DE600DL纳米膜层磁控溅射系统配备多个磁控溅射源,可沉积金属、半导体、介质材料. 可用于溅射多层薄膜、共溅合金薄膜、反应溅射、可选溅射楔形膜等。是材料和薄膜沉积研发和中试的理想平台。
特点
溅射距离可调
PID下游和上游压力控制
良好的薄膜均匀性和重复性
安全互锁保护
可选离子束清洗或辅助沉积
可选溅射楔形膜
可选RF等离子体清洗
PLC和工控全自动控制
主要配置
镀膜腔室:不锈钢腔体
真空阀门:高真空插板阀门
真空测量:宽量程真空计
溅射源:6个以上溅射源、直流、脉冲直流、射频电源、HIPPIMS电源
样品台:样品台旋转加热或冷却
气体和压力控制:多路气体配流量计、PID控制压力控制
预真空样品室:单基片或多基片装载能力、全自动送样
主要技术指标
镀膜腔室极限真空度:优于3E-8Torr(或9E-9Torr)
基片尺寸:可选:2英寸、4英寸、6英寸、8英寸、12英寸
样品加热器最高温度:600℃(可选900℃)
膜厚均匀性:优于+/-3%
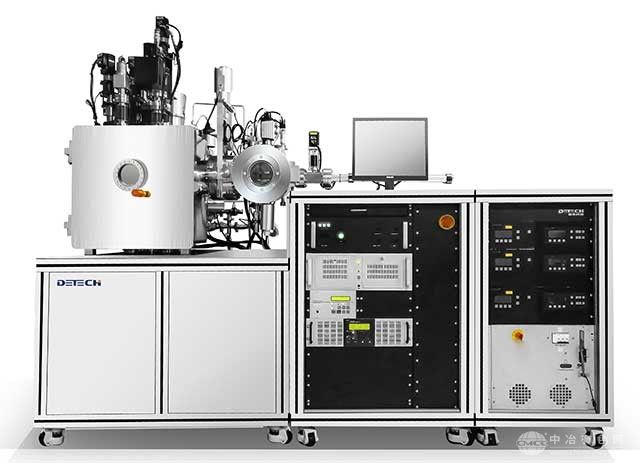
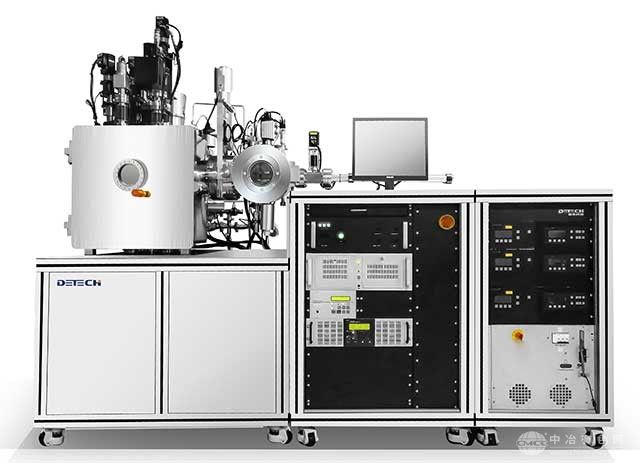





 京公网安备 11010702002294号
京公网安备 11010702002294号
